
進(jìn)行逆變器設計時(shí)��,IGBT模塊的開(kāi)關(guān)損耗評估是很重要的一個(gè)環(huán)節�。而常見(jiàn)的損耗評估方法都是采用數據手冊中IGBT或者Diode的開(kāi)關(guān)損耗的典型值����,這種方法缺乏一定的準確性��。本文介紹了一種采用逆變器系統的驅動(dòng)板和母排對IGBT模塊進(jìn)行損耗測試和評估的方法����,通過(guò)簡(jiǎn)單的操作即可得到更精確的損耗評估���。

一般數據手冊中�,都會(huì )給出特定條件下���,IGBT及Diode開(kāi)關(guān)損耗的典型值�。一般來(lái)講這個(gè)值在實(shí)際設計中并不能直接拿來(lái)用�。在英飛凌模塊數據手冊中��,我們可以看到���,開(kāi)關(guān)損耗典型值前面�,有相當多的限制條件�����,這些條件描述了典型值測試平臺�。而實(shí)際設計的系統是不可能和規格書(shū)測試平臺一模一樣的��。兩者之間的差異����,主要體現在如下幾個(gè)方面:
IGBT的開(kāi)關(guān)損耗不僅僅依賴(lài)于驅動(dòng)電阻�,也依賴(lài)于驅動(dòng)環(huán)路的電感�����,而實(shí)際用戶(hù)系統的驅動(dòng)環(huán)路電感常常不同于數據手冊的測試平臺的驅動(dòng)環(huán)路電感��。
驅動(dòng)中加入柵極和發(fā)射極電容是很常見(jiàn)的改善EMC特性的設計方法����,而使用該柵極電容會(huì )影響IGBT的開(kāi)關(guān)過(guò)程中電流變化率dIc / dt和電壓變化率dVce / dt��,從而影響IGBT的開(kāi)關(guān)損耗
實(shí)際系統的驅動(dòng)電壓也常常不同于數據手冊中的測試驅動(dòng)電壓����,在IGBT模塊的數據手冊中��,開(kāi)關(guān)損耗通常在±15V的柵極電壓下測量��,而用戶(hù)的驅動(dòng)電壓有時(shí)也并非這個(gè)電壓數值�����。
數據手冊通常會(huì )在較小的母排雜散電感下進(jìn)行開(kāi)關(guān)損耗測試�,而實(shí)際系統的母排或者PCB的布局常常會(huì )存在比較大的雜散電感���。

正因為實(shí)際系統的母排�、驅動(dòng)與數據手冊的標準測試平臺的母排�、驅動(dòng)存在著(zhù)差異�����,才導致了直接采用數據手冊的開(kāi)關(guān)損耗進(jìn)行實(shí)際系統的損耗評估存在著(zhù)一定的誤差��。一種改善的方式是直接采用實(shí)際系統的母排和驅動(dòng)來(lái)進(jìn)行雙脈沖測試��,IGBT模塊可以固定在一個(gè)加熱平臺上���,而加熱平臺能夠調節到150℃并保持恒溫����。
圖1給出了雙脈沖的測試原理圖����,圖2給出了雙脈沖測試時(shí)的波形圖����,典型的雙脈沖測試可以按照圖1和圖2 進(jìn)行�,同時(shí)需要注意將加熱平臺調整到一定的溫度��,并等待一定時(shí)間�,確保IGBT的結溫也到達設定溫度����。
 圖1-1: IGBT的雙脈沖測試原理圖
圖1-1: IGBT的雙脈沖測試原理圖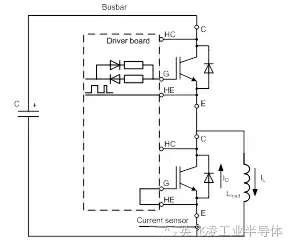 圖1-2: Diode的雙脈沖測試原理圖
圖1-2: Diode的雙脈沖測試原理圖 圖2-1: IGBT的雙脈沖測試波形圖
圖2-1: IGBT的雙脈沖測試波形圖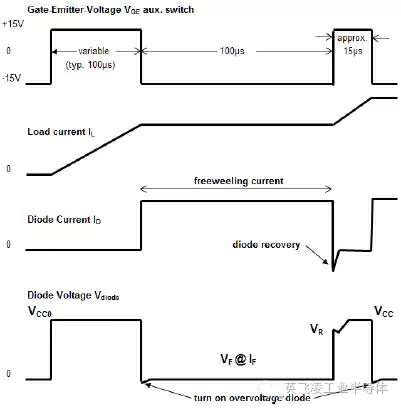 圖2-2:Diode的雙脈沖測試波形圖
圖2-2:Diode的雙脈沖測試波形圖圖3給出了雙脈沖測試過(guò)程中�����,IGBT的開(kāi)通過(guò)程和關(guān)斷過(guò)程的波形���。損耗可以通過(guò)CE電壓和導通電流的乘積后的積分來(lái)獲得��。需要注意的是電壓探頭和電流探頭需要匹配延時(shí)��,否則會(huì )引起比較大的測試誤差�。在用于數據手冊的測試平臺中����,常見(jiàn)的電流探頭是PEARSON探頭�����,而實(shí)際系統的母排中���,很難裝入PEARSON探頭���,更多的采用Rogowski-coil�����。需要注意的是Rogowski-coil 的延時(shí)會(huì )比較大��,而且當電流變化率超過(guò)3600 A/μs時(shí)�����,Rogowski-coil 會(huì )有比較明顯的誤差��。關(guān)于測試探頭和延時(shí)匹配也可同儀器廠(chǎng)家確認���。
 圖3-1 IGBT關(guān)斷過(guò)程
圖3-1 IGBT關(guān)斷過(guò)程DUT:FF600R12ME4; CH2(綠色)- VGE�,CH 3(藍色)- ce�����,CH4(紅色)- Ic
 圖3-2 IGBT開(kāi)通過(guò)程
圖3-2 IGBT開(kāi)通過(guò)程
首先固定電壓和溫度����,在不同的電流下測試IGBT的開(kāi)關(guān)損耗���,可以得出損耗隨電流變化的曲線(xiàn)�����,并且對曲線(xiàn)進(jìn)行擬合���,可以得到損耗的表達式����。該系統的直流母線(xiàn)電壓最小為540V�����,最高為700V��。而系統的IGBT的結溫的設計在125℃和150℃之間�����。分別在540V和700V母線(xiàn)電壓����,及125℃和150℃結溫下重復上述測試�����,可以得到一系列曲線(xiàn)����,如圖4所示����。
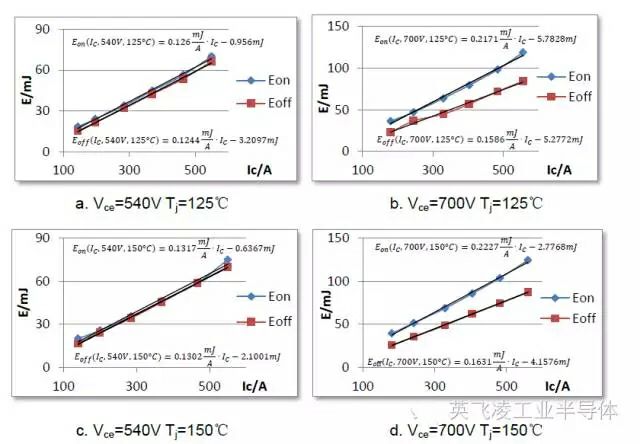 圖4:在不同的電流輸入條件下�����,以電壓和溫度為給定條件的IGBT的開(kāi)關(guān)損耗曲線(xiàn)
圖4:在不同的電流輸入條件下�����,以電壓和溫度為給定條件的IGBT的開(kāi)關(guān)損耗曲線(xiàn)依據圖4給出的損耗測試曲線(xiàn)����,可以依據線(xiàn)性等效的方法得到IGBT的開(kāi)通損耗和關(guān)斷損耗在電流��,電壓�,結溫下的推導公式�。

同理也可以得到Diode在給定系統的電壓����,電流���,結溫設計范圍內的反向恢復損耗的推導公式:
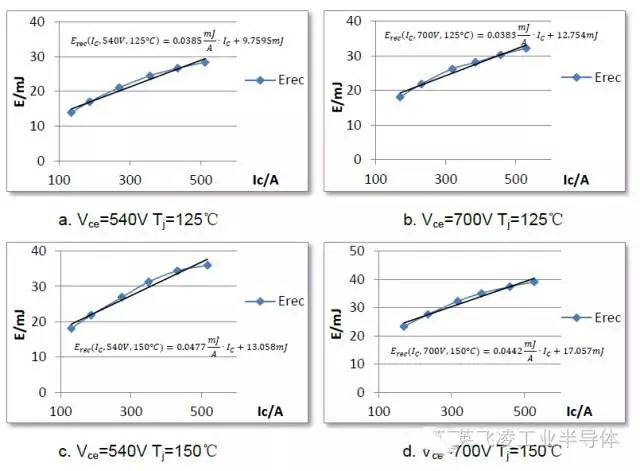 圖5:在不同的電流輸入條件下����,以電壓和溫度為給定條件的Diode反向恢復損耗曲線(xiàn)
圖5:在不同的電流輸入條件下����,以電壓和溫度為給定條件的Diode反向恢復損耗曲線(xiàn)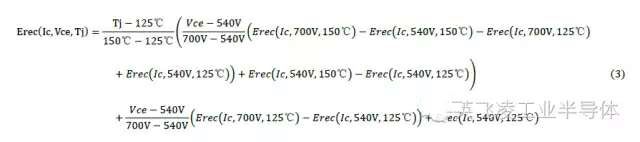

雖然這里介紹的方法相對于采用IGBT數據手冊的開(kāi)關(guān)損耗典型值提供了一些改進(jìn)����,但仍存在一些缺點(diǎn)��,比如在非常低的電流時(shí)����,損耗會(huì )有一定的誤差����,這可以通過(guò)采用非線(xiàn)性模型或多級的電流線(xiàn)性模型來(lái)優(yōu)化����。

通過(guò)采用實(shí)際系統的驅動(dòng)和母排進(jìn)行雙脈沖測試���,在系統設計的電壓��,電流和溫度范圍內��,可以得到比采用數據手冊的典型值更準確的損耗評估�。(英飛凌igbt廠(chǎng)家)



 英飛凌igbt銷(xiāo)售
英飛凌igbt銷(xiāo)售